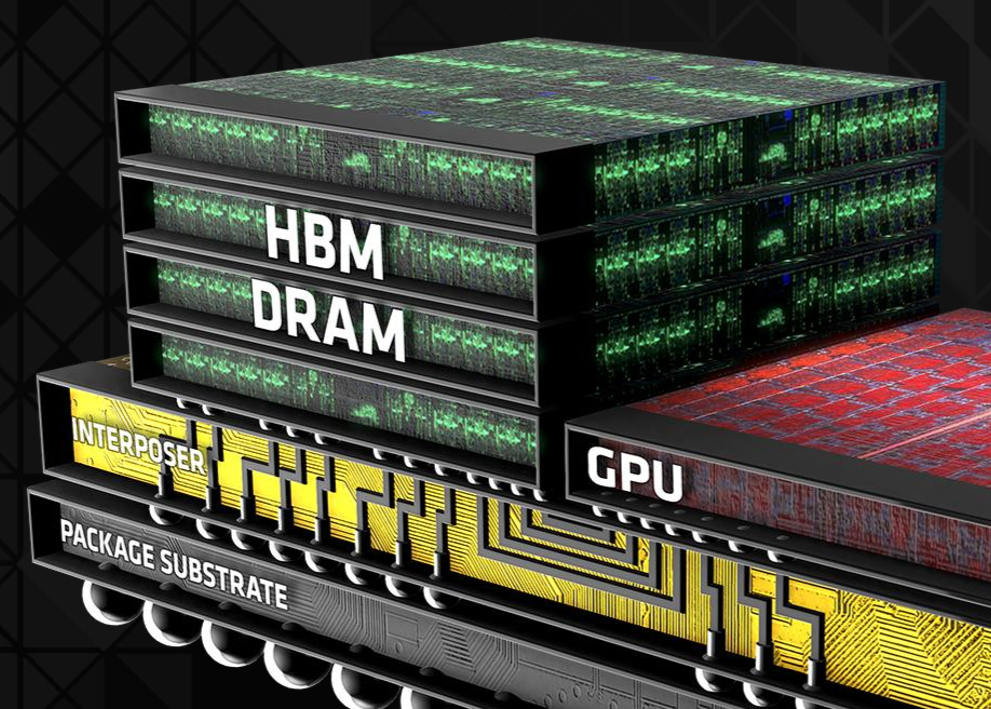
Samsung planea adoptar la tecnología de unión híbrida para su HBM4 para reducir las térmicas y permitir una interfaz de memoria ultra ancha, reveló la compañía en el Foro de Semiconductores de IA en Seúl, Corea del Sur. Por el contrario, el rival SK Hynix de la compañía podría retrasar la adopción de la tecnología de vinculación híbrida, informa EBN.
Memoria de alto ancho de banda (HBM) Apila múltiples dispositivos de memoria sobre un dado base. Por ahora, los troqueles de memoria en las pilas HBM se unen típicamente utilizando microbumps (que llevan datos, potencia y señales de control entre los troqueles apilados) y la unión se realiza utilizando técnicas como reflujo de masa con un solo relleno moldeado (MR-MUF) o compresión térmica utilizando una película no conductiva (TC-NCF).
Estos troqueles también se interconectan verticalmente utilizando VIA de silicio (TSV) incrustados dentro de cada dado (que llevan datos, reloj, señales de control, potencia y tierra a través de cada dado de DRAM). Sin embargo, a medida que HBM se vuelve más rápido y gana el número de dispositivos DRAM, las microbumps se vuelven ineficientes a medida que limitan el rendimiento y la eficiencia energética.
Aquí es donde entra en juego la unión híbrida. La unión híbrida es una técnica de integración 3D que conecta directamente las matrices uniendo las superficies de cobre a cobre y óxido a óxido, eliminando la necesidad de microbuertas. La unión híbrida admite lanzamientos de interconexión por debajo de 10 µm, ofreciendo una menor resistencia y capacitancia, mayor densidad, mejor rendimiento térmico en comparación con el apilamiento tradicional basado en la protuberancia y las pilas 3D más delgadas.
Sin embargo, hay un problema. La unión híbrida es una técnica bastante costosa y, aunque los tres fabricantes líderes de memoria HBM lo consideraron para HBM3E, Micron y Samsung de 12 HI, terminaron usando TC-NCF, mientras que SK Hynix usa MR-MUF. Con HBM4, Samsung planea usar la unión híbrida, mientras que SK Hynix está desarrollando una técnica MR-MUF avanzada, así como la unión híbrida como un proceso de respaldo.
Hay una razón por la cual SK Hynix puede usar un relleno moldeado tradicional en lugar de unión híbrida. El equipo especializado necesario para la unión híbrida es significativamente más costoso que las herramientas de envasado convencionales y requiere un espacio físico sustancialmente más en Fabs.
Esto afecta la eficiencia de capital, particularmente cuando el área de piso FAB es limitada. Como resultado, SK Hynix continúa con cautela. Si descubre que su técnica MR-MUF avanzada proporciona los mismos (o similares) resultados de rendimiento y buenos rendimientos, preferirá quedarse con MR-MUF para al menos una generación más.
Otra razón por la cual SK Hynix puede quedarse con MR-MUF para una generación más es que su MR-MUF avanzado permite pilas de memoria HBM más delgadas que los insuficiencia de generación anterior. Esto permite a la compañía producir pilas HBM4 de 16 HI que cumplen con las especificaciones HBM4 de JEDEC que exigen la altura máxima del paquete de un paquete HBM4 a 775 µm, lo cual es un poco más corto en comparación con ~ 800 µm de altura máxima de 16 HBM3E de 16 HI. Si SK Hynix puede cumplir con las especificaciones de Jedec con herramientas y tecnologías existentes, hace que el uso de la unión híbrida sea considerablemente menos atractiva para la empresa.
Samsung tiene su propio fabricante de herramientas Fab, Semes, que reduce de alguna manera sus costos fabulosos. Sin embargo, no está claro si SEMES puede producir herramientas de unión híbridas avanzadas para su empresa matriz por ahora.
No obstante, la vinculación híbrida es una tecnología que se usará en el futuro de todos modos, por lo que la industria está observando si Samsung puede calificar su HBM4 utilizando la unión híbrida. La calificación exitosa podría remodelar el paisaje competitivo, dando a Samsung una ventaja tecnológica y comercial en rendimiento, características térmicas y densidad de señal. Como resultado, Samsung puede recuperar la cuota de mercado de Micron y SK Hynix con su HBM4 después de iniciar su producción en masa en 2026.
Seguir Hardware de Tom en Google News Para obtener nuestras noticias, análisis y revisiones actualizadas en sus feeds. Asegúrese de hacer clic en el botón Forzar.